|
제 18 장 건식도금
식도금은 CVD(Chemical Vapor Deposition)과 PVD(Physical Vapor Deposition)으로 분류할 수 있으며, 표 18-1과 같다. 건식도금기술은 소재(基板, substrate)에 엷은 금속 또는 금속화합물을 피복시킨다는 의미에서 박막(薄膜) 제조기술(thin film technology)이라는 말을 많이 사용하고 있다.
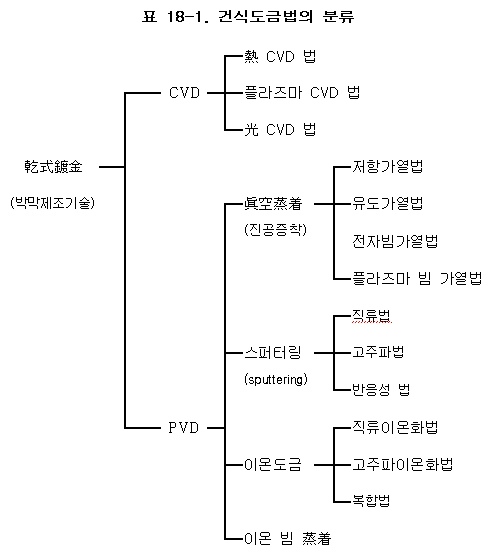
18. 1. CVD(화학적 기상도금)
CVD(Chemical Vapor Deposition) 化學蒸着(화학증착) 또는 그대로 氣相鍍金(기상도금)이라고도 한다. CVD는 반도체의 제조공정에서 가장 중요한 기술의 하나이며, 역사적으로는 1920년대에 고순도의 금속을 얻는 방법으로 요오드(iodine)법 등이 등장했다.
1940년대부터는 고순도 게르마늄, 실리콘의 제조법 등의 반도체공업에 깊은 관계를 갖게 되었고 1970년대에는 반도체 集積(집적)기술의 발달과 더불어 고순도, 고품질의 박막형성에 없어서는 안 될 기술로 발전되었다.
고융점의 텅스텐, 탄소, 탄화물, 질화물, 산화물, 규화물 등의 내산화성, 내마모성, 내식성 등의 우수한 피막을 형성하여 종래의 재료에 새로운 기능성을 부여했으며, 1950년대부터 로켓 노즐, 원자로 연료의 피복등에 이용되기 시작했고, 그 후 TiC, TiN을 피복한 초경공구의 제조에 사용되게 되었다. 최근에는 핵융합로의 내벽의 보호막, 태양전지의 유력한 제조법의 하나로 주목되고 있다.
18. 1. 1. CVD의 특징
처리온도가 1000℃인 상당히 높은 온도에서 피막을 하며 우수한 밀착성을 얻을 수 있다.
가. 장점
1) 1000℃의 고온에서 형성된 피막은 母材(모재)와 확산 또는 반응으로 우수한 밀착성이 얻어진다.
2) 도금원료가 가스상태로 공급되므로 복잡한 형태도 비교적 용이하게 균일도금이 된다 (ex; 파이프의 내면, 입자나 미립자등에도 도금 가능)
3) 도금속도가 1~3.5μm/min도 가능하여 mm단위의 두께도 도금이 가능하다. 4) 多成分系(다성분계)의 피복도 용이하고 공해가 적다.
나. 단점
1) 도금(코팅)하고자 하는 재료를 가스화할 수 있어야 하며, 도금할 재료(substrate)표면과 적당한 화학작용이 있어야 하므로 적용범위가 한정된다. 2) 소재(substrate)는 고온으로 가열되어야 할 필요가 있으므로, 가열할 수 없는 물체는 적용할 수 없다.
3) 처리온도가 매우 높으므로 처리중 모재의 변형, 변질을 가져오기도 하고 모재와의 경계면에 취약층이 생겨서 피막의 밀착성을 해칠 수 있다.
18. 2. PVD(물리적 기상도금)
PVD(Physical Vapor Deposition, 물리적 기상도금)은 CVD(Chemical Vapor Deposition, 화학적 기상도금)과 구별하기 위한 명칭이며, 물리적 증발도금이라고도 말하며 세가지로 분류한다.
18. 2. 1. 진공증착법(vacuum metallizing)
진공 중에서 금속, 금속화합물 또는 합금을 가열 증발시켜서 증발금속 또는 증발금속화합물을 목적물질의 표면에 응축하게 하여 蕅膜(우막, thin film)을 형성시키는 방법으로 진공도금법(vacuum metallizing)이라고도 한다.
진공증착은 증발되는 가스가 많으므로 도금속도는 크나, 증발입자가 가지고 있는 에너지가 열에너지뿐이어서 적으므로 밀착강도가 적고, 증발가스는 광선과 같이 직선적이기 때문에 뒷면 등은 도금이 되지 않으므로 기판을 회전시키면서 도금해야 한다. 도금물체는 금속, 비금속 모두 가능하다.
18. 2. 2. 음극 스퍼터링(cathode sputtering)
진공 속에 아르곤(argon)같은 불활성가스를 넣고 직류를 통하면 음극에서 전자가 튀어나와 기체분자와 충돌한다. 충돌한 분자의 일부만 이온화가 되며 대부분은 이온화되지 못하고 여기(勵起: excitation)되며 곧 원래의 안정한 상태로 되돌아간다. 이때 글로(glow)라는 광선을 발하며 방전하여 글로방전이라고 하고, 플라스마(plasma, 이온과 전자가 공존하여 전체적으로 중성을 유지하고 있는 상태)에는 항상 나타나기 마련이다. 음극스퍼터링은 이 플라스마 속의 이온(Ar + 같은)을 음극의 음전기의 힘으로 음극쪽에 가속시켜 음극물질을 튕겨내서(증발시켜서) 기관에 부착(도금)되게 하는 현상을 말한다. 이 음극판을 타깃(target)이라고 한다. 또한 이온이 음극을 때릴 때 열도 발생하므로 열에 의해 증발되는 입자도 있다.
다시 말해 음극스퍼터링은 각 입자가 열에너지와 플라스마에 의해 이온화가 된 가스가 음극에 이끌리면서 충돌하여 튕겨진 입자가 큰 운동에너지를 가지고 있으므로 진공증발 입자보다 10 3 ~10 5 배의 에너지 값을 가지고 힘있게 입사하게 되어 막이 치밀하고 밀착도 좋다. 그러나 스퍼터입자의 수가 적으므로 도금속도가 느리다.
18. 2. 3. 이온도금(ion plating)
이온도금은 미국의 Mattox가 1964년에 개발한 것으로서 진공증착은 금속을 증발시켜 직접 凝着鍍金(응착도금)하는데 비해 이온도금은 증발금속을 일단 이온화시켜서 음극에 전착시키는 것을 말하며, 증발된 입자가 플라스마 속을 통과하면서 이온화하고 스퍼터와 같은 고에너지를 가지고 도금이 되므로 도금속도도 크고 밀착도 좋으며 뒷면도 도금이 된다.
증발입자를 이온화시키는 것은 일단 아르곤가스 등을 플라스마화시키고 이 플라스마층을 증발입자가 통과하는 동안 전자에 얻어 맞고 +이온으로 되어 음극에 이끌려 충돌하게 된다. 그러나 음극인 피도금체(기판)에는 이온뿐만 아니고 증발원자(분자), 전자, 가스분자 등도 入射(입사)하게 된다.
가. 이온도금의 종류
1) MATTOX법
Ar 가스를 도입하여 플라스마를 발생시키고, 증발금속을 이 플라스마를 통과하게 하여 이온화시킨다.
2) 고주파(RF)이온화법
대부분 13.56MHz의 고주파를 이용하여 10 -4 Torr(10 -2 Pa) 정도의 비교적 고진공에서 불활성 가스를 이온화시키거나 증발물을 이온화시키기도 하고, 절연체도 도금이 가능하다.
3) 多陰極(다음극)이온화법
복수의 열음극을 설치하여 이들 열음극으로부터 튀어나오는 전자를 증발입자에 충돌시켜서 이온화하는 방법으로 역시 불활성 가스 또는 반응가스를 사용할 수 있다.
4) 이외에도 다수의 이온화법이 있다.
| 